–°—А–Њ—З–љ–∞—П –њ—Г–±–ї–Є–Ї–∞—Ж–Є—П –љ–∞—Г—З–љ–Њ–є —Б—В–∞—В—М–Є
+7 995 770 98 40
+7 995 202 54 42
info@journalpro.ru
–†–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л–µ —Н–ї–µ–Љ–µ–љ—В—Л –≤ —А–Њ–ї–Є –≤–љ—Г—В—А–µ–љ–љ–Є—Е –≥–µ—В—В–µ—А–Њ–≤ –≤ –Ї—А–µ–Љ–љ–Є–Є –Є –Ї—А–µ–Љ–љ–Є–µ–≤—Л—Е —Б—В—А—Г–Ї—В—Г—А–∞—Е —Б –њ—А–Є–Љ–µ—Б—П–Љ–Є —В—Г–≥–Њ–њ–ї–∞–≤–Ї–Є—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤
–†—Г–±—А–Є–Ї–∞: –§–Є–Ј–Є–Ї–Њ-–Љ–∞—В–µ–Љ–∞—В–Є—З–µ—Б–Ї–Є–µ –љ–∞—Г–Ї–Є
–Ц—Г—А–љ–∞–ї: « –Х–≤—А–∞–Ј–Є–є—Б–Ї–Є–є –Э–∞—Г—З–љ—Л–є –Ц—Г—А–љ–∞–ї вДЦ9 2019» (—Б–µ–љ—В—П–±—А—М, 2019)
–Ъ–Њ–ї–Є—З–µ—Б—В–≤–Њ –њ—А–Њ—Б–Љ–Њ—В—А–Њ–≤ —Б—В–∞—В—М–Є: 2537
–Я–Њ–Ї–∞–Ј–∞—В—М PDF –≤–µ—А—Б–Є—О –†–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л–µ —Н–ї–µ–Љ–µ–љ—В—Л –≤ —А–Њ–ї–Є –≤–љ—Г—В—А–µ–љ–љ–Є—Е –≥–µ—В—В–µ—А–Њ–≤ –≤ –Ї—А–µ–Љ–љ–Є–Є –Є –Ї—А–µ–Љ–љ–Є–µ–≤—Л—Е —Б—В—А—Г–Ї—В—Г—А–∞—Е —Б –њ—А–Є–Љ–µ—Б—П–Љ–Є —В—Г–≥–Њ–њ–ї–∞–≤–Ї–Є—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤
–Ф–∞–ї–Є–µ–≤ –®.–•.
PhD, —Б—В–∞—А—И–Є–є –љ–∞—Г—З–љ—Л–є —Б–Њ—В—А—Г–і–љ–Є–Ї
–Э–Ш–Ш —Д–Є–Ј–Є–Ї–Є –њ–Њ–ї—Г–њ—А–Њ–≤–Њ–і–љ–Є–Ї–Њ–≤ –Є –Љ–Є–Ї—А–Њ—Н–ї–µ–Ї—В—А–Њ–љ–Є–Ї–Є
–Э–∞—Ж–Є–Њ–љ–∞–ї—М–љ–Њ–≥–Њ —Г–љ–Є–≤–µ—А—Б–Є—В–µ—В–∞ –£–Ј–±–µ–Ї–Є—Б—В–∞–љ–∞
–≥. –Ґ–∞—И–Ї–µ–љ—В, –†–µ—Б–њ—Г–±–ї–Є–Ї–∞ –£–Ј–±–µ–Ї–Є—Б—В–∞–љ
E-mail: shakhrukhd@mail.ru
–Р–љ–љ–Њ—В–∞—Ж–Є—П. –° –њ–Њ–Љ–Њ—Й—М—О –љ–µ—Б—В–∞—Ж–Є–Њ–љ–∞—А–љ–Њ–є –µ–Љ–Ї–Њ—Б—В–љ–Њ–є —Б–њ–µ–Ї—В—А–Њ—Б–Ї–Њ–њ–Є–Є –≥–ї—Г–±–Њ–Ї–Є—Е —Г—А–Њ–≤–љ–µ–є –Є—Б—Б–ї–µ–і–Њ–≤–∞–љ—Л –њ—А–Њ—Ж–µ—Б—Б—Л –Њ–±—А–∞–Ј–Њ–≤–∞–љ–Є—П –і–µ—Д–µ–Ї—В–Њ–≤ –≤ n-–Ї—А–µ–Љ–љ–Є–Є, –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ–Њ–Љ –≥–∞—Д–љ–Є–µ–Љ, –≤–Њ–ї—М—Д—А–∞–Љ–Њ–Љ –Є –Љ–Њ–ї–Є–±–і–µ–љ–Њ–Љ –Є –≤–ї–Є—П–љ–Є—П –љ–∞ —Н—В–Є –њ—А–Њ—Ж–µ—Б—Б—Л –њ—А–Є–Љ–µ—Б–µ–є —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤ вАФ –µ–≤—А–Њ–њ–Є—П –Є –і–Є—Б–њ—А–Њ–Ј–Є—П. –Я–Њ–Ї–∞–Ј–∞–љ–Њ, —З—В–Њ –њ—А–Є—Б—Г—В—Б—В–≤–Є–µ –њ—А–Є–Љ–µ—Б–µ–є —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤ –≤ —А–µ—И–µ—В–Ї–µ –Ї—А–µ–Љ–љ–Є—П —Б—Г—Й–µ—Б—В–≤–µ–љ–љ–Њ –њ–Њ–≤—Л—И–∞–µ—В —А–∞—Б—В–≤–Њ—А–Є–Љ–Њ—Б—В—М –њ—А–Є–Љ–µ—Б–µ–є —В—Г–≥–Њ–њ–ї–∞–≤–Ї–Є—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤ (Hf, W –Є–ї–Є Mo) –≤ –Ї—А–µ–Љ–љ–Є–Є –Є –Њ–і–љ–Њ–≤—А–µ–Љ–µ–љ–љ–Њ —Б–љ–Є–ґ–∞–µ—В —Н—Д—Д–µ–Ї—В–Є–≤–љ–Њ—Б—В—М –Њ–±—А–∞–Ј–Њ–≤–∞–љ–Є—П —В–µ—А–Љ–Њ–і–µ—Д–µ–Ї—В–Њ–≤. –≠—В–Њ —Б–≤–Є–і–µ—В–µ–ї—М—Б—В–≤—Г–µ—В –Њ —В–Њ–Љ, —З—В–Њ –њ—А–Є–Љ–µ—Б–Є —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤ –≤ Si –≤—Л—Б—В—Г–њ–∞—О—В –≤ —А–Њ–ї–Є –≤–љ—Г—В—А–µ–љ–љ–Є—Е –≥–µ—В—В–µ—А–Њ–≤ –і–ї—П —А–∞–Ј–ї–Є—З–љ—Л—Е –і–µ—Д–µ–Ї—В–Њ–≤ –≤ –Њ–±—К–µ–Љ–µ –Ї—А–µ–Љ–љ–Є—П, –∞ —В–∞–Ї–ґ–µ –љ–µ–Ї–Њ–љ—В—А–Њ–ї–Є—А—Г–µ–Љ—Л—Е —В–µ—Е–љ–Њ–ї–Њ–≥–Є—З–µ—Б–Ї–Є—Е –њ—А–Є–Љ–µ—Б–µ–є.
–Ъ–ї—О—З–µ–≤—Л–µ —Б–ї–Њ–≤–∞: –Ї—А–µ–Љ–љ–Є–є, –ї–µ–≥–Є—А–Њ–≤–∞–љ–Є–µ, –і–Є—Д—Д—Г–Ј–Є—П, –≥–∞—Д–љ–Є–є, –≤–Њ–ї—М—Д—А–∞–Љ,
–Љ–Њ–ї–Є–±–і–µ–љ, –µ–≤—А–Њ–њ–Є–є –Є –і–Є—Б–њ—А–Њ–Ј–Є–є, –≥–ї—Г–±–Њ–Ї–Є–є —Г—А–Њ–≤–µ–љ—М.
RARE EARTH ELEMENTS AS INTERNAL GETTERS IN SILICON AND SILICON STRUCTURES WITH IMPURITIES OF REFRACTORY ELEMENTS
Daliev Sh.Kh.
PhD, senior researcher
Research Institute of physics of semiconductors and microelectronics
National University of Uzbekistan, Tashkent, Republic of Uzbekistan
e-mail: shakhrukhd@mail.ru
Annotation. The processes of formation of defects in n-silicon doped with hafnium, tungsten and molybdenum and the influence of admixtures of rare earth elements вАФ europium and dysprosium-on these processes were studied using unsteady capacitive spectroscopy of deep levels. It is shown that the presence of impurities of rare earth elements in the silicon lattice significantly increases the solubility of impurities of refractory elements (Hf, W or Mo) in silicon and at the same time reduces the efficiency of formation of thermal defects. This indicates that the impurities of rare earth elements in Si act as internal getters for various defects in the silicon volume, as well as uncontrolled technological impurities.
Keywords: silicon, alloying, diffusion, hafnium, tungsten, molybdenum, europium and dysprosium, deep level.
–Ш–Ј–≤–µ—Б—В–љ–Њ, —З—В–Њ –љ–∞ –њ—А–Њ—Ж–µ—Б—Б—Л –і–µ—Д–µ–Ї—В–Њ–Њ–±—А–∞–Ј–Њ–≤–∞–љ–Є—П –Ј–∞–Љ–µ—В–љ–Њ–µ –≤–ї–Є—П–љ–Є–µ –Њ–Ї–∞–Ј—Л–≤–∞—О—В —А–∞–Ј–ї–Є—З–љ—Л–µ —Д–∞–Ї—В–Њ—А—Л
–°—А–µ–і–Є –њ–µ—А–µ—З–Є—Б–ї–µ–љ–љ—Л—Е —Д–∞–Ї—В–Њ—А–Њ–≤ –љ–∞–Є–±–Њ–ї—М—И–Є–є –Є–љ—В–µ—А–µ—Б –њ—А–µ–і—Б—В–∞–≤–ї—П—О—В –њ—А–Є–Љ–µ—Б–Є —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤ (–†–Ч–≠), –≤–≤–µ–і–µ–љ–љ—Л–µ –≤ –Ї—А–µ–Љ–љ–Є–є –≤ –њ—А–Њ—Ж–µ—Б—Б–µ –≤—Л—А–∞—Й–Є–≤–∞–љ–Є—П –Є–Ј —А–∞—Б–њ–ї–∞–≤–∞[3-4]. –Ш–Ј–≤–µ—Б—В–љ–Њ, —З—В–Њ –њ—А–Є–Љ–µ—Б–Є —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤, —Е–Є–Љ–Є—З–µ—Б–Ї–Є –∞–Ї—В–Є–≤–љ—Л–µ –Є —Б–Ї–ї–Њ–љ–љ—Л–µ –Ї –Ї–Њ–Љ–њ–ї–µ–Ї—Б–Њ–Њ–±—А–∞–Ј–Њ–≤–∞–љ–Є—О –і–∞–ґ–µ –њ—А–Є –љ–µ–±–Њ–ї—М—И–Є—Е –Ї–Њ–љ—Ж–µ–љ—В—А–∞—Ж–Є—П—Е, –≤–≤–µ–і–µ–љ–љ—Л–µ –≤ –Ї—А–µ–Љ–љ–Є–Є –њ—А–Є –≤—Л—А–∞—Й–Є–≤–∞–љ–Є–Є –љ–∞—Е–Њ–і—П—В—Б—П –≤ –µ–≥–Њ —А–µ—И–µ—В–Ї–µ –≤ —Н–ї–µ–Ї—В—А–Є—З–µ—Б–Ї–Є –љ–µ–є—В—А–∞–ї—М–љ—Л—Е —Б–Њ—Б—В–Њ—П–љ–Є—П—Е. –Ъ—А–Њ–Љ–µ —В–Њ–≥–Њ, –њ—А–Є–Љ–µ—Б–Є —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤, –љ–µ –њ—А–Њ—П–≤–ї—П—П —Н–ї–µ–Ї—В—А–Є—З–µ—Б–Ї–Њ–є –∞–Ї—В–Є–≤–љ–Њ—Б—В–Є, –≤—Б—В—Г–њ–∞—О—В –≤–Њ –≤–Ј–∞–Є–Љ–Њ–і–µ–є—Б—В–≤–Є—П —Б —А–∞–Ј–ї–Є—З–љ—Л–Љ–Є –љ–µ–Ї–Њ–љ—В—А–Њ–ї–Є—А—Г–µ–Љ—Л–Љ–Є –њ—А–Є–Љ–µ—Б—П–Љ–Є –≤ –Ї—А–µ–Љ–љ–Є–Є
–Ш–Ј–≤–µ—Б—В–љ–Њ, —З—В–Њ –ї–µ–≥–Є—А–Њ–≤–∞–љ–Є–µ Si —В—Г–≥–Њ–њ–ї–∞–≤–Ї–Є–Љ–Є —Н–ї–µ–Љ–µ–љ—В–∞–Љ–Є (–Ґ–Я–≠) —Б—Г—Й–µ—Б—В–≤–µ–љ–љ–Њ –≤–ї–Є—П–µ—В –љ–∞ —А–∞–±–Њ—З–Є–µ —Е–∞—А–∞–Ї—В–µ—А–Є—Б—В–Є–Ї–Є –њ–Њ–ї—Г–њ—А–Њ–≤–Њ–і–љ–Є–Ї–Њ–≤—Л—Е –њ—А–Є–±–Њ—А–Њ–≤
–Т —Б–≤—П–Ј–Є —Б —Н—В–Є–Љ —Ж–µ–ї—М—О –і–∞–љ–љ–Њ–є —А–∞–±–Њ—В—Л —П–≤–ї—П–ї–Њ—Б—М –Є—Б—Б–ї–µ–і–Њ–≤–∞–љ–Є–µ –њ—А–Њ—Ж–µ—Б—Б–Њ–≤ –і–µ—Д–µ–Ї—В–Њ–Њ–±—А–∞–Ј–Њ–≤–∞–љ–Є—П –≤ n-–Ї—А–µ–Љ–љ–Є–Є, –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ–Њ–Љ –≥–∞—Д–љ–Є–µ–Љ, –≤–Њ–ї—М—Д—А–∞–Љ–Њ–Љ –Є –Љ–Њ–ї–Є–±–і–µ–љ–Њ–Љ –Є –≤–ї–Є—П–љ–Є—П –љ–∞ —Н—В–Є –њ—А–Њ—Ж–µ—Б—Б—Л –њ—А–Є–Љ–µ—Б–µ–є —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤ вАФ –µ–≤—А–Њ–њ–Є—П –Є –і–Є—Б–њ—А–Њ–Ј–Є—П. –Ш—Б—Б–ї–µ–і–Њ–≤–∞–љ–Є—П –њ—А–Њ–≤–Њ–і–Є–ї–Є—Б—М —Б –њ–Њ–Љ–Њ—Й—М—О –Є–Ј–Љ–µ—А–µ–љ–Є–є —Б–њ–µ–Ї—В—А–Њ–≤ –љ–µ—Б—В–∞—Ж–Є–Њ–љ–∞—А–љ–Њ–є –µ–Љ–Ї–Њ—Б—В–љ–Њ–є —Б–њ–µ–Ї—В—А–Њ—Б–Ї–Њ–њ–Є–Є (DLTS).
–Т –Ї–∞—З–µ—Б—В–≤–µ –Є—Б—Б–ї–µ–і—Г–µ–Љ—Л—Е –Њ–±—А–∞–Ј—Ж–Њ–≤ –Є—Б–њ–Њ–ї—М–Ј–Њ–≤–∞–ї—Б—П –Љ–Њ–љ–Њ–Ї—А–Є—Б—В–∞–ї–ї–Є—З–µ—Б–Ї–Є–є –Ї—А–µ–Љ–љ–Є–є n-—В–Є–њ–∞ –њ—А–Њ–≤–Њ–і–Є–Љ–Њ—Б—В–Є —Б —Г–і–µ–ї—М–љ—Л–Љ —Б–Њ–њ—А–Њ—В–Є–≤–ї–µ–љ–Є–µ–Љ r=5√Ј20 –Ю–Љ√Ч—Б–Љ –Є —Б–Њ–і–µ—А–ґ–∞–љ–Є–µ–Љ –Љ–µ–ґ-–і–Њ—Г–Ј–µ–ї—М–љ–Њ–≥–Њ –Њ–њ—В–Є—З–µ—Б–Ї–Є –∞–Ї—В–Є–≤–љ–Њ–≥–Њ –Ї–Є—Б–ї–Њ—А–Њ–і–∞ N–Ю–Њ–њ—В –≤ –Є–љ—В–µ—А–≤–∞–ї–µ = 1.2√Ч1016√Ј 7.3√Ч1017—Б–Љ-3. –Ы–µ–≥–Є—А–Њ–≤–∞–љ–Є–µ –Ї—А–µ–Љ–љ–Є—П —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л–Љ–Є —Н–ї–µ–Љ–µ–љ—В–∞–Љ–Є вАФ –µ–≤—А–Њ–њ–Є–µ–Љ Eu –Є –і–Є—Б–њ—А–Њ–Ј–Є–µ–Љ Dy –њ—А–Њ–Є–Ј–≤–Њ–і–Є–ї–Њ—Б—М –њ—А–Є –≤—Л—А–∞—Й–Є–≤–∞–љ–Є–Є –Ї—А–µ–Љ–љ–Є—П –Є–Ј —А–∞—Б–њ–ї–∞–≤–∞.
–Ъ—А–µ–Љ–љ–Є–є, –њ—А–µ–і–≤–∞—А–Є—В–µ–ї—М–љ–Њ –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ—Л–є –Њ–і–љ–Њ–є –Є–Ј –њ—А–Є–Љ–µ—Б–µ–є –†–Ч–≠ вАФ Eu –Є–ї–Є Dy, –≤ –њ—А–Њ—Ж–µ—Б—Б–µ –≤—Л—А–∞—Й–Є–≤–∞–љ–Є—П –Є–Ј —А–∞—Б–њ–ї–∞–≤–∞, –і–∞–ї–µ–µ –ї–µ–≥–Є—А–Њ–≤–∞–ї—Б—П –≥–∞—Д–љ–Є–µ–Љ, –≤–Њ–ї—М—Д—А–∞–Љ–Њ–Љ –Є–ї–Є –Љ–Њ–ї–Є–±–і–µ–љ–Њ–Љ –і–Є—Д—Д—Г–Ј–Є–Њ–љ–љ—Л–Љ –Љ–µ—В–Њ–і–Њ–Љ –≤ –Є–љ—В–µ—А–≤–∞–ї–µ —В–µ–Љ–њ–µ—А–∞—В—Г—А 1000-1200¬∞–° –≤ —В–µ—З–µ–љ–Є–µ 2 —З–∞—Б–Њ–≤ –Є–Ј –љ–∞–љ–µ—Б–µ–љ–љ–Њ–≥–Њ –љ–∞ –њ–Њ–≤–µ—А—Е–љ–Њ—Б—В—М Si —Б–ї–Њ—П –Љ–µ—В–∞–ї–ї–Є—З–µ—Б–Ї–Њ–≥–Њ Hf, W –Є–ї–Є Mo. –Ф–ї—П –њ—А–Њ–≤–µ–і–µ–љ–Є—П –Є–Ј–Љ–µ—А–µ–љ–Є–є —Б–њ–µ–Ї—В—А–Њ–≤ DLTS –≤ –Є—Б—Б–ї–µ–і—Г–µ–Љ—Л—Е –Њ–±—А–∞–Ј—Ж–∞—Е –њ–Њ—Б–ї–µ –ї–µ–≥–Є—А–Њ–≤–∞–љ–Є—П –њ—А–Є–Љ–µ—Б—П–Љ–Є –Ґ–Я–≠, –љ–∞ –њ–ї–∞—Б—В–Є–љ–∞—Е n-Si<Hf>, n-Si<W> –Є n-Si<Mo> —Б –Њ—А–Є–µ–љ—В–∞—Ж–Є–µ–є <100> –Є —Г–і–µ–ї—М–љ—Л–Љ —Б–Њ–њ—А–Њ—В–Є–≤–ї–µ–љ–Є–µ–Љ r=5¬Є20 –Ю–Љ√Ч—Б–Љ –Є–Ј–≥–Њ—В–∞–≤–ї–Є–≤–∞–ї–Є—Б—М –і–Є–Њ–і–љ—Л–µ —Б—В—А—Г–Ї—В—Г—А—Л –њ–Њ –Є–Ј–≤–µ—Б—В–љ–Њ–є –Љ–µ—В–Њ–і–Є–Ї–µ [8]. –Ш–Ј–Љ–µ—А–µ–љ–Є—П –Є –Њ–±—А–∞–±–Њ—В–Ї–∞ —Б–њ–µ–Ї—В—А–Њ–≤ —В–∞–Ї–ґ–µ –і–µ—В–∞–ї—М–љ–Њ –Њ–њ–Є—Б–∞–љ—Л –≤ —А–∞–±–Њ—В–∞—Е [8,9]. –Ш–Ј –Т–§–• –Њ–њ—А–µ–і–µ–ї–µ–љ—Л –Ј–∞–≤–Є—Б–Є–Љ–Њ—Б—В–Є 1/–°2=f(V–Њ–±—А), –Ї–Њ—В–Њ—А—Л–µ –≤–Њ –≤—Б–µ—Е –Є—Б—Б–ї–µ–і–Њ–≤–∞–љ–љ—Л—Е –і–Є–Њ–і–∞—Е –±—Л–ї–Є –ї–Є–љ–µ–є–љ—Л–Љ–Є.
–Р–љ–∞–ї–Є–Ј —Б–њ–µ–Ї—В—А–Њ–≤ DLTS –њ–Њ–Ї–∞–Ј—Л–≤–∞–µ—В, —З—В–Њ –≤–≤–µ–і–µ–љ–Є–µ –µ–≤—А–Њ–њ–Є—П –Є–ї–Є –і–Є—Б–њ—А–Њ–Ј–Є—П –≤ –Ї—А–µ–Љ–љ–Є–є –≤ –њ—А–Њ—Ж–µ—Б—Б–µ –≤—Л—А–∞—Й–Є–≤–∞–љ–Є—П Si –Є–Ј —А–∞—Б–њ–ї–∞–≤–∞ –љ–µ –њ—А–Є–≤–Њ–і–Є—В –Ї –Њ–±—А–∞–Ј–Њ–≤–∞–љ–Є—О –Ї–∞–Ї–Є—Е-–ї–Є–±–Њ –≥–ї—Г–±–Њ–Ї–Є—Е —Г—А–Њ–≤–љ–µ–є –≤ –Ј–∞–њ—А–µ—Й–µ–љ–љ–Њ–є –Ј–Њ–љ–µ –Ї—А–µ–Љ–љ–Є—П, —Е–Њ—В—П –њ–Њ –і–∞–љ–љ—Л–Љ –љ–µ–є—В—А–Њ–љ–љ–Њ-–∞–Ї—В–Є–≤–∞—Ж–Є–Њ–љ–љ–Њ–≥–Њ –∞–љ–∞–ї–Є–Ј–∞ –∞—В–Њ–Љ—Л Eu –Є Dy –њ—А–Є—Б—Г—В—Б—В–≤—Г—О—В –≤ –Њ–±—К–µ–Љ–µ –Ї—А–µ–Љ–љ–Є—П –≤ –і–Њ—Б—В–∞—В–Њ—З–љ–Њ –≤—Л—Б–Њ–Ї–Њ–є –Ї–Њ–љ—Ж–µ–љ—В—А–∞—Ж–Є–Є (3¬Ј1015-6¬Ј1017—Б–Љ-3). –≠—В–Њ—В —Д–∞–Ї—В —Б–≤–Є–і–µ—В–µ–ї—М—Б—В–≤—Г–µ—В –Њ —В–Њ–Љ, —З—В–Њ –∞—В–Њ–Љ—Л –µ–≤—А–Њ–њ–Є—П –Є –і–Є—Б–њ—А–Њ–Ј–Є—П , –≤–≤–µ–і–µ–љ–љ—Л–µ –њ—А–Є –≤—Л—А–∞—Й–Є–≤–∞–љ–Є–Є, —Н–ї–µ–Ї—В—А–Є—З–µ—Б–Ї–Є –љ–µ–є—В—А–∞–ї—М–љ—Л.
–Ш–Ј –Є–Ј–Љ–µ—А–µ–љ–Є–є —Б–њ–µ–Ї—В—А–Њ–≤ DLTS –Њ–±—А–∞–Ј—Ж–Њ–≤ Si, –њ—А–µ–і–≤–∞—А–Є—В–µ–ї—М–љ–Њ –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ—Л—Е Eu –Є–ї–Є Dy, –Ј–∞—В–µ–Љ –і–Є—Д—Д—Г–Ј–Є–Њ–љ–љ–Њ-–ї–µ–≥–Є—А–Њ–≤–∞–љ–љ—Л—Е Hf, W –Є–ї–Є Mo, –∞ —В–∞–Ї–ґ–µ –Ї–Њ–љ—В—А–Њ–ї—М–љ—Л—Е –Њ–±—А–∞–Ј—Ж–Њ–≤, –њ–Њ–і–≤–µ—А–≥–љ—Г—В—Л—Е —В–µ—А–Љ–Њ–Њ–±—А–∞–±–Њ—В–Ї–µ (–±–µ–Ј –њ—А–Є–Љ–µ—Б–µ–є –Ґ–Я–≠) –Њ–њ—А–µ–і–µ–ї—П–ї—Б—П —Н–љ–µ—А–≥–µ—В–Є—З–µ—Б–Ї–Є–є —Б–њ–µ–Ї—В—А –Њ–±—А–∞–Ј—Г–µ–Љ—Л—Е –≥–ї—Г–±–Њ–Ї–Є—Е —Г—А–Њ–≤–љ–µ–є (–У–£). –Э–∞ —А–Є—Б.1 –њ—А–Є–≤–µ–і–µ–љ—Л —Б–њ–µ–Ї—В—А—Л DLTS –Њ–±—А–∞–Ј—Ж–Њ–≤ n-Si, –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ–Њ–≥–Њ –≤–Њ–ї—М—Д—А–∞–Љ–Њ–Љ –њ—А–Є 1200–Њ–° —Б –њ–Њ—Б–ї–µ–і—Г—О—Й–Є–Љ –±—Л—Б—В—А—Л–Љ –Њ—Е–ї–∞–ґ–і–µ–љ–Є–µ–Љ (–Ї—А–Є–≤–∞—П 1) –Є n-Si, –њ—А–µ–і–≤–∞—А–Є—В–µ–ї—М–љ–Њ –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ–Њ–≥–Њ –µ–≤—А–Њ–њ–Є–µ–Љ –≤ –њ—А–Њ—Ж–µ—Б—Б–µ –≤—Л—А–∞—Й–Є–≤–∞–љ–Є—П –Ї—А–µ–Љ–љ–Є—П –Є–Ј —А–∞—Б–њ–ї–∞–≤–∞, –Ј–∞—В–µ–Љ –і–Њ–њ–Њ–ї–љ–Є—В–µ–ї—М–љ–Њ –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ–Њ–≥–Њ, –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ–Њ–≥–Њ –≤–Њ–ї—М—Д—А–∞–Љ–Њ–Љ –њ—А–Є 1200–Њ–° (–Ї—А–Є–≤–∞—П 2) –Є –Ї–Њ–љ—В—А–Њ–ї—М–љ–Њ–≥–Њ n-Si (–Ї—А–Є–≤–∞—П 3).
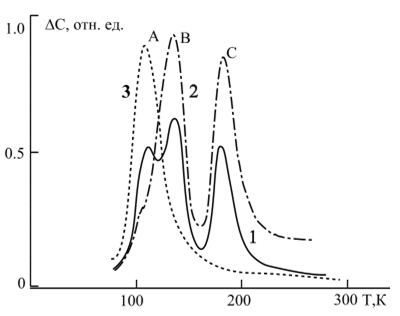
–†–Є—Б.1. –°–њ–µ–Ї—В—А—Л DLTS –Њ–±—А–∞–Ј—Ж–Њ–≤ n-Si<W> (–Ї—А–Є–≤–∞—П 1) –Є n-Si<Eu,W>
(–Ї—А–Є–≤–∞—П 2) –Є –Ї–Њ–љ—В—А–Њ–ї—М–љ–Њ–≥–Њ n-Si (–Ї—А–Є–≤–∞—П 3).
–Ш–Ј –∞–љ–∞–ї–Є–Ј–∞ –Є–Ј–Љ–µ—А–µ–љ–љ—Л—Е —Б–њ–µ–Ї—В—А–Њ–≤ DLTS –Њ–±—А–∞–Ј—Ж–Њ–≤ n-Si<W> (—А–Є—Б.1, –Ї—А–Є–≤–∞—П 1) —Б–ї–µ–і—Г–µ—В, —З—В–Њ –і–Є—Д—Д—Г–Ј–Є–Њ–љ–љ–Њ–µ –≤–≤–µ–і–µ–љ–Є–µ W –≤ Si –њ—А–Є–≤–Њ–і–Є—В –Ї –Њ–±—А–∞–Ј–Њ–≤–∞–љ–Є—О —В—А–µ—Е –≥–ї—Г–±–Њ–Ї–Є—Е —Г—А–Њ–≤–љ–µ–є –≤ –≤–µ—А—Е–љ–µ–є –њ–Њ–ї–Њ–≤–Є–љ–µ –Ј–∞–њ—А–µ—Й–µ–љ–љ–Њ–є –Ј–Њ–љ—Л —Б —Д–Є–Ї—Б–Є—А–Њ–≤–∞–љ–љ—Л–Љ–Є —Н–љ–µ—А–≥–Є—П–Љ–Є –Є–Њ–љ–Є–Ј–∞—Ж–Є–Є –Х—Б-0.22 —Н–Т (–њ–Є–Ї –Р), –Х—Б-0.30 —Н–Т (–њ–Є–Ї B) –Є –Х—Б-0.39 —Н–Т (–њ–Є–Ї C), –њ—А–Є—З–µ–Љ –њ—А–µ–≤–∞–ї–Є—А—Г–µ—В –≤—В–Њ—А–Њ–є –У–£.
–Р–љ–∞–ї–Є–Ј —Б–њ–µ–Ї—В—А–Њ–≤ DLTS –Ї–Њ–љ—В—А–Њ–ї—М–љ—Л—Е —В–µ—А–Љ–Њ–Њ–±—А–∞–±–Њ—В–∞–љ–љ—Л—Е –Њ–±—А–∞–Ј—Ж–Њ–≤ n-Si –њ–Њ–Ї–∞–Ј–∞–ї, —З—В–Њ –≤ –љ–Є—Е –љ–∞–±–ї—О–і–∞–µ—В—Б—П –ї–Є—И—М —Г—А–Њ–≤–µ–љ—М —Б —Н–љ–µ—А–≥–Є–µ–є –Є–Њ–љ–Є–Ј–∞—Ж–Є–Є –Х—Б- 0.22 —Н–Т (–њ–Є–Ї –Р), –њ—А–Є—З–µ–Љ –µ–≥–Њ –Ї–Њ–љ—Ж–µ–љ—В—А–∞—Ж–Є—П –Ј–љ–∞—З–Є—В–µ–ї—М–љ–Њ –≤—Л—И–µ, —З–µ–Љ –≤ –Њ–±—А–∞–Ј—Ж–∞—Е, –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ—Л—Е W. –Ю—В—Б—О–і–∞ –Љ–Њ–ґ–љ–Њ —Б–і–µ–ї–∞—В—М –≤—Л–≤–Њ–і, —З—В–Њ —Б –∞—В–Њ–Љ–∞–Љ–Є –≤–Њ–ї—М—Д—А–∞–Љ–∞ –≤ n-Si<W> —Б–≤—П–Ј–∞–љ—Л –ї–Є—И—М —Г—А–Њ–≤–љ–Є —Б —Н–љ–µ—А–≥–Є—П–Љ–Є –Є–Њ–љ–Є–Ј–∞—Ж–Є–Є –Х—Б вИТ0.30 —Н–Т, –Х—Б-0.39 —Н–Т, –∞ —Г—А–Њ–≤–µ–љ—М –Х—Б-0.22 —Н–Т —П–≤–ї—П–µ—В—Б—П, –≤–µ—А–Њ—П—В–љ–Њ, –і–µ—Д–µ–Ї—В–Њ–Љ —В–µ—А–Љ–Њ–Њ–±—А–∞–±–Њ—В–Ї–Є.
–°–Њ–њ–Њ—Б—В–∞–≤–ї–µ–љ–Є–µ –Ї—А–Є–≤—Л—Е 1 –Є 2 –љ–∞ —Б–њ–µ–Ї—В—А–∞—Е DLTS –Њ–±—А–∞–Ј—Ж–Њ–≤ n-Si<W> (—А–Є—Б.1) –њ–Њ–Ї–∞–Ј—Л–≤–∞–µ—В, —З—В–Њ –њ—А–Є—Б—Г—В—Б—В–≤–Є–µ –≤ —А–µ—И–µ—В–Ї–µ –Ї—А–µ–Љ–љ–Є—П –њ—А–Є–Љ–µ—Б–Є –†–Ч–≠, –≤ –і–∞–љ–љ–Њ–Љ —Б–ї—Г—З–∞–µ Eu, –њ—А–Є–≤–Њ–і–Є—В –Ї —В—А–∞–љ—Б—Д–Њ—А–Љ–∞—Ж–Є–Є —Б–њ–µ–Ї—В—А–Њ–≤ DLTS: –Ї–Њ–љ—Ж–µ–љ—В—А–∞—Ж–Є–Є —Г—А–Њ–≤–љ–µ–є, —Б–≤—П–Ј–∞–љ–љ—Л—Е —Б –∞—В–Њ–Љ–∞–Љ–Є –≤–Њ–ї—М—Д—А–∞–Љ–∞ —Г–≤–µ–ї–Є—З–Є–≤–∞—О—В—Б—П –≤ 2 —А–∞–Ј–∞ –≤ n-Si<Eu,W> –њ–Њ —Б—А–∞–≤–љ–µ–љ–Є—О —Б n-Si<W>. –°–ї–µ–і—Г–µ—В –Њ—В–Љ–µ—В–Є—В—М, —З—В–Њ –Ї–Њ–љ—Ж–µ–љ—В—А–∞—Ж–Є—П –У–£ –Х—Б-0.22 —Н–Т, –Њ–±—Г—Б–ї–Њ–≤–ї–µ–љ–љ–Њ–≥–Њ —В–µ—А–Љ–Њ–і–µ—Д–µ–Ї—В–∞–Љ–Є, –Ј–љ–∞—З–Є—В–µ–ї—М–љ–Њ —Г–Љ–µ–љ—М—И–∞–µ—В—Б—П –≤ –њ—А–Є—Б—Г—В—Б—В–≤–Є–Є –∞—В–Њ–Љ–Њ–≤ –µ–≤—А–Њ–њ–Є—П, —В–Њ –µ—Б—В—М –∞—В–Њ–Љ—Л –†–Ч–≠ –њ—А–µ–њ—П—В—Б—В–≤—Г—О—В –Њ–±—А–∞–Ј–Њ–≤–∞–љ–Є—О —В–µ—А–Љ–Њ–і–µ—Д–µ–Ї—В–Њ–≤.
–Ю—В–Љ–µ—В–Є–Љ, —З—В–Њ –∞–љ–∞–ї–Њ–≥–Є—З–љ–∞—П –Ї–∞—А—В–Є–љ–∞ –љ–∞–±–ї—О–і–∞–ї–∞—Б—М –Є –≤ –Њ–±—А–∞–Ј—Ж–∞—Е n-Si<Hf> –Є n-Si<Mo>. –Э–∞ —А–Є—Б.2 –њ—А–Є–≤–µ–і–µ–љ—Л —Б–њ–µ–Ї—В—А—Л DLTS –Њ–±—А–∞–Ј—Ж–Њ–≤ n-Si, –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ–Њ–≥–Њ Hf .
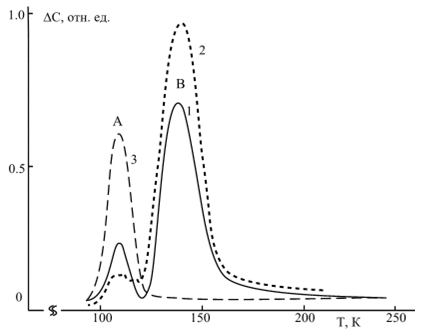
–†–Є—Б.2. –°–њ–µ–Ї—В—А—Л DLTS –Њ–±—А–∞–Ј—Ж–Њ–≤ n-Si<Hf> (–Ї—А–Є–≤–∞—П 1) –Є n-Si<Dy,Hf>
(–Ї—А–Є–≤–∞—П 2) –Є –Ї–Њ–љ—В—А–Њ–ї—М–љ–Њ–≥–Њ n-Si (–Ї—А–Є–≤–∞—П 3).
–Ъ–∞–Ї –≤–Є–і–љ–Њ –Є–Ј –∞–љ–∞–ї–Є–Ј–∞ —Н—В–Њ–≥–Њ —А–Є—Б—Г–љ–Ї–∞, –њ—А–Є—Б—Г—В—Б—В–≤–Є–µ –∞—В–Њ–Љ–Њ–≤ –і–Є—Б–њ—А–Њ–Ј–Є—П –≤ –Њ–±—К–µ–Љ–µ –Ї—А–µ–Љ–љ–Є—П, —В–∞–Ї–ґ–µ –Ї–∞–Ї –Є –∞—В–Њ–Љ–Њ–≤ –µ–≤—А–Њ–њ–Є—П, —Г–≤–µ–ї–Є—З–Є–≤–∞–µ—В —А–∞—Б—В–≤–Њ—А–Є–Љ–Њ—Б—В—М –∞—В–Њ–Љ–Њ–≤ –≥–∞—Д–љ–Є—П, –њ—А–Є —Н—В–Њ–Љ —Г–Љ–µ–љ—М—И–∞–µ—В—Б—П –Ї–Њ–љ—Ж–µ–љ—В—А–∞—Ж–Є—П —Г—А–Њ–≤–љ–µ–є –Х—Б-0.22 —Н–Т, —Б–≤—П–Ј–∞–љ–љ–Њ–≥–Њ —Б —В–µ—А–Љ–Њ–і–µ—Д–µ–Ї—В–∞–Љ–Є. –°—А–∞–≤–љ–µ–љ–Є–µ –Ї—А–Є–≤—Л—Е 1 –Є 2 –љ–∞ —А–Є—Б.1 –Є —А–Є—Б.2 –њ–Њ–Ї–∞–Ј—Л–≤–∞–µ—В, —З—В–Њ –≥–µ—В—В–µ—А–Є—А—Г—О—Й–Є–є —Н—Д—Д–µ–Ї—В –∞—В–Њ–Љ–Њ–≤ –µ–≤—А–Њ–њ–Є—П –њ—А–Њ—П–≤–ї—П–µ—В—Б—П —Б–Є–ї—М–љ–µ–µ.
–Ґ–∞–Ї–Є–Љ –Њ–±—А–∞–Ј–Њ–Љ, –Љ–Њ–ґ–љ–Њ —Б–і–µ–ї–∞—В—М –≤—Л–≤–Њ–і, —З—В–Њ –њ—А–Є—Б—Г—В—Б—В–≤–Є–µ –њ—А–Є–Љ–µ—Б–µ–є —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤ –≤ –Њ–±—К–µ–Љ–µ –Ї—А–µ–Љ–љ–Є—П, —Б—Г—Й–µ—Б—В–≤–µ–љ–љ–Њ –њ–Њ–≤—Л—И–∞–µ—В —А–∞—Б—В–≤–Њ—А–Є–Љ–Њ—Б—В—М –њ—А–Є–Љ–µ—Б–µ–є —В—Г–≥–Њ–њ–ї–∞–≤–Ї–Є—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤ (Hf, W –Є–ї–Є Mo) –≤ –Ї—А–µ–Љ–љ–Є–Є –Є –Њ–і–љ–Њ–≤—А–µ–Љ–µ–љ–љ–Њ —Б–љ–Є–ґ–∞–µ—В —Н—Д—Д–µ–Ї—В–Є–≤–љ–Њ—Б—В—М –Њ–±—А–∞–Ј–Њ–≤–∞–љ–Є—П —В–µ—А–Љ–Њ–і–µ—Д–µ–Ї—В–Њ–≤. –≠—В–Њ —Б–≤–Є–і–µ—В–µ–ї—М—Б—В–≤—Г–µ—В –Њ —В–Њ–Љ, —З—В–Њ –њ—А–Є–Љ–µ—Б–Є —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л—Е —Н–ї–µ–Љ–µ–љ—В–Њ–≤ –≤ Si –≤—Л—Б—В—Г–њ–∞—О—В –≤ —А–Њ–ї–Є –≤–љ—Г—В—А–µ–љ–љ–Є—Е –≥–µ—В—В–µ—А–Њ–≤ –і–ї—П —А–∞–Ј–ї–Є—З–љ—Л—Е –і–µ—Д–µ–Ї—В–Њ–≤ –≤ –Њ–±—К–µ–Љ–µ –Ї—А–µ–Љ–љ–Є—П, –∞ —В–∞–Ї–ґ–µ –љ–µ–Ї–Њ–љ—В—А–Њ–ї–Є—А—Г–µ–Љ—Л—Е —В–µ—Е–љ–Њ–ї–Њ–≥–Є—З–µ—Б–Ї–Є—Е –њ—А–Є–Љ–µ—Б–µ–є.
–Ы–Є—В–µ—А–∞—В—Г—А–∞:
- –С—Г—А–≥—Г—Н–љ –Ц., –Ы–∞–љ–љ–Њ –Ь. –Ґ–Њ—З–µ—З–љ—Л–µ –і–µ—Д–µ–Ї—В—Л –≤ –њ–Њ–ї—Г–њ—А–Њ–≤–Њ–і–љ–Є–Ї–∞—Е. –Ґ–µ–Њ—А–Є—П. –Ь., –Ь–Є—А, 1984, 264 —Б.
- –Ч–Њ–ї–Њ—В—Г—Е–Є–љ –Ш.–Т., –Ъ–∞–ї–Є–љ–Є–љ –Ѓ.–Х., –°—В–Њ–љ–≥–µ–є –Ю.–Т. –Э–Њ–≤—Л–µ –љ–∞–њ—А–∞–≤–ї–µ–љ–Є—П —Д–Є–Ј–Є—З–µ—Б–Ї–Њ–≥–Њ –Љ–∞—В–µ—А–Є–∞–ї–Њ–≤–µ–і–µ–љ–Є—П. –Т–Њ—А–Њ–љ–µ–ґ: –Ш–Ј–і. –Т–Њ—А–Њ–љ–µ–ґ—Б–Ї–Њ–≥–Њ –≥–Њ—Б—Г–љ–Є–≤–µ—А—Б–Є—В–µ—В–∞, 2000, 360 —Б.
- –®–Є–љ–і–Є—З –Т.–Ы. –Ш—Б—Б–ї–µ–і–Њ–≤–∞–љ–Є–µ –њ—А–Њ—Ж–µ—Б—Б–Њ–≤ —А–∞–і–Є–∞—Ж–Є–Њ–љ–љ–Њ–≥–Њ –і–µ—Д–µ–Ї—В–Њ–Њ–±—А–∞–Ј–Њ–≤–∞–љ–Є—П –≤ Si, –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ–Њ–Љ –†–Ч–≠. –Р–≤—В–Њ—А–µ—Д.–Ї–∞–љ–і.–і–Є—Б—Б., –Ъ–Є–µ–≤, 1982, 17 —Б.
- Castaldini A., Cavallini A., Fraboni B., Pizzini S.. On the role of extended defects in the transport properties of Er-doped silicon. Phil. Magazine B, 2000, Vol.80, P.571-577.
- –Ы–∞–Ј–∞—А—Г–Ї –°.–Ъ., –Ь—Г–і—А—Л–є –Р.–Т., –Ш–≤–∞–љ—О–Ї–Њ–≤–Є—З –Р.–Т., –Ы–µ—И–Њ–Ї –Р.–Р., –£–љ—Г—З–µ–Ї –Ф.–Э., –Ы–∞–±—Г–љ–Њ–≤ –Т.–Р. –§–Њ—В–Њ–ї—О–Љ–Є–љ–µ—Б—Ж–µ–љ—Ж–Є—П –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ—Л—Е —Н—А–±–Є–µ–Љ –∞–ї—О–Љ–Њ–Њ–Ї—Б–Є–і–љ—Л—Е –њ–ї–µ–љ–Њ–Ї —Б–Њ –≤—Б—В—А–Њ–µ–љ–љ—Л–Љ–Є –Ї—А–µ–Љ–љ–Є–µ–≤—Л–Љ–Є –љ–∞–љ–Њ—З–∞—Б—В–Є—Ж–∞–Љ–Є. –§–Ґ–Я, 2005, –Ґ. 39, –Т. 8, –°.
927-930. - –Х–Љ—Ж–µ–≤ –Т. –Т., –Х–Љ—Ж–µ–≤ –Т. –Т. (–Љ–ї.), –Я–Њ–ї–Њ—Б–Ї–Є–љ –Ф. –°, –°–Њ–±–Њ–ї–µ–≤ –Э. –Р., –®–µ–Ї –Х.–Ш., –Ь–Є—Е–µ–ї—М –Щ., –Ъ–Є–Љ–µ—А–ї–Є–љ–≥ –Ы.–°. –Я—А–Є–Љ–µ—Б–љ—Л–µ —Ж–µ–љ—В—А—Л –≤ –Ї—А–µ–Љ–љ–Є–Є, –ї–µ–≥–Є—А–Њ–≤–∞–љ–љ–Њ–Љ —А–µ–і–Ї–Њ–Ј–µ–Љ–µ–ї—М–љ—Л–Љ–Є –њ—А–Є–Љ–µ—Б—П–Љ–Є –і–Є—Б–њ—А–Њ–Ј–Є–µ–Љ, –≥–Њ–ї—М–Љ–Є–µ–Љ, —Н—А–±–Є–µ–Љ –Є –Є—В—В–µ—А–±–Є–µ–Љ. –§–Ґ–Я, 1999, –Ґ. 33, –Т—Л–њ. 6, –°.649-651.
- Daliev Sh. Kh., Vlasov S.I. Nonequilibrium processes in MIS-structures on the basis of silicon, doped with hafnium. Journal of Scientific and Engineering Research (JSAER), 2017, 4(4), p.11-13.
- Daliev Sh.Kh., Paluanova A.D. Influence of ќ≥-radiation properties of wolframium levels in silicon. Science and world. 2018. вДЦ 10 (62). Vol. I, p.28-31.
- –Ф–∞–ї–Є–µ–≤ –®.–•. –Т–ї–Є—П–љ–Є–µ –њ—А–Є–Љ–µ—Б–µ–є Zr, Ti –Ш Hf –љ–∞ —Н–ї–µ–Ї—В—А–Њ—Д–Є–Ј–Є—З–µ—Б–Ї–Є–µ —Б–≤–Њ–є—Б—В–≤–∞ –Ї—А–µ–Љ–љ–Є–µ–≤—Л—Е —Б—В—А—Г–Ї—В—Г—А. –Р–≤—В–Њ—А–µ—Д.–і–Њ–Ї—В.–і–Є—Б—Б. –Ґ–∞—И–Ї–µ–љ—В, 2017, 47 —Б.









